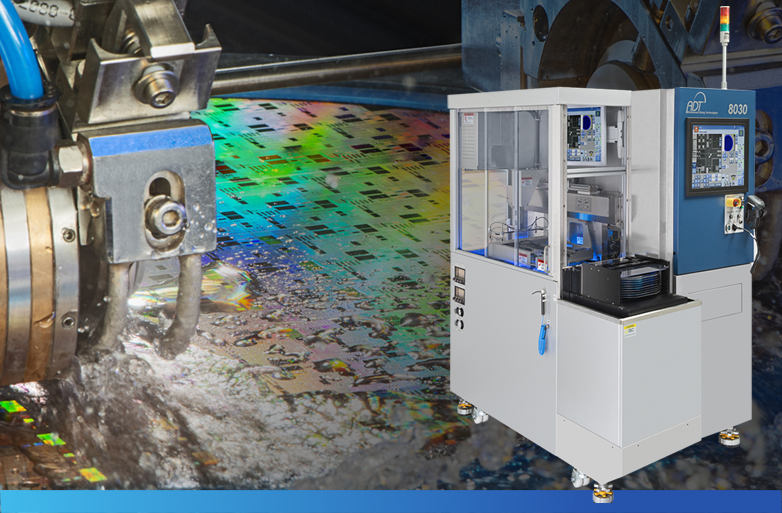
選擇適合您應用的正確刀片對於切割製程的成功至關重要。ADT的刀片選擇分為三個產品系列,根據結合材料進行區分:樹脂結合刀片、鎳結合刀片和金屬結合(燒結)刀片。


Copyright © ADT – Advanced Dicing Technologies, 2025
ADT – a leading developer & global supplier of high-performance Dicing Solutions, including Dicing Saws, Dicing Blades, Dicing Peripherals, and a complete range of Accessories — engineered for precision, built for excellence.
Design Maxmark
